前言:為什麼薄膜厚度量測很重要?
在電子、光學、半導體等領域,薄膜的厚度與光學性質常常直接影響元件性能與可靠性。
若無法正確量測薄膜厚度或光學常數(折射率 nn、消光係數 k),產品可能偏離設計規格、導致效能不良。
本文將比較兩種主流光學量測技術 —— 顯微分光法(reflection spectroscopy / 微型反射干涉法)與 橢圓偏光法(ellipsometry),探討它們的原理、優缺點與適用場景,幫助你選擇最適合的薄膜量測方法。
目錄
- 光學薄膜厚度量測的基本原理
- 顯微分光法(含反射分光法)介紹
- 橢圓偏光法介紹
- 顯微分光 vs 橢圓偏光:比較表與案例分析
- 選擇策略:什麼時候用哪一法?
- 應用示例與注意事項
- 結語與未來展望
1. 光學薄膜厚度量測的基本原理
光學式薄膜厚度量測的優勢在於非接觸、不破壞樣品,還能量測光學參數(n,k)。
目前常見的方法可歸為兩類:
- 反射分光法 / 顯微分光法:利用反射光的干涉現象分析膜厚與折射率
- 橢圓偏光法:分析入射光與反射光之偏振相位差,計算膜厚與光學參數
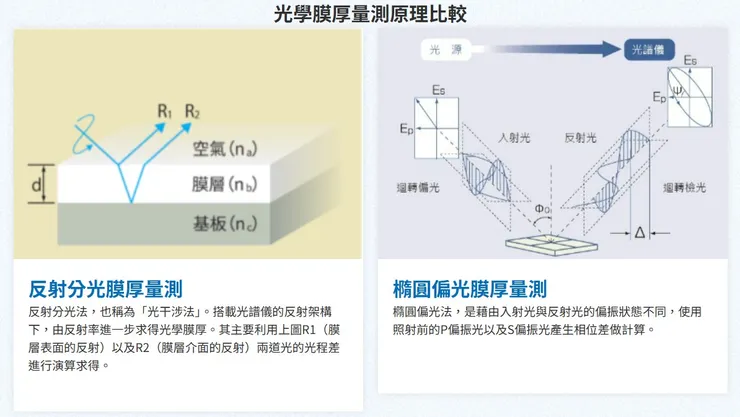
這兩種方法各有優勢與限制,適合不同應用條件。
2. 顯微分光法(反射分光法 + 顯微鏡結合)
原理簡述
在系統中設計反射架構,收集從薄膜表面及內部介面的反射光(R1、R2),透過光路差干涉演算法,從反射率隨波長變化的曲線中回推膜厚與折射率。
如果在系統中加入微型鏡頭或顯微鏡構造,就稱為顯微分光法。
優點
- 可搭配顯微鏡觀察,量測小區域(spot size 可下探數 µm)
- 可處理透明、半透明、有色薄膜,尤其若光譜儀具多波段能力
- 量測範圍廣(可從 nm 等級到µm)
- 量測速度快,可在對焦後在 1 秒內完成量測
- 對基板不透明或結構複雜樣品更具彈性
限制
- 當膜非常薄時(如 < 10 nm),干涉訊號可能較弱,誤差較大
- 若樣品表面粗糙或光學異方性強,可能干擾干涉模式
- 需有適當校正與參考樣本以提升精度
3. 橢圓偏光法(Ellipsometry)
原理簡述
橢圓偏光法利用偏振光(P、S 偏振分量)入射薄膜,在反射後產生偏振變化。量測入射與反射光之間的相位差與振幅比,可透過模型擬合得到膜厚與 n,k。
優點
- 對於超薄膜(10 nm 以下)具有較高靈敏度
- 可提供更多光學參數(如光學常數)資訊
- 在模型與參數條件足夠正確的情況下,解析更精細
限制
- 分析模型較複雜,參數多,對用戶技術門檻高
- 量測時間較長(因須多角度取偏振光資料)
- 偏振法對某些有色膜、吸收膜、或基板不透光的情況有侷限
- 光斑通常較大,不適合極小結構或局部量測
4. 顯微分光 vs 橢圓偏光 — 技術比較
下表將這兩法在主要參數上的差異做對比:

案例舉例:
- 顯微分光法(如 OPTM 系列)量測範圍可達 1 nm ~ 多十 µm,且具備可對焦 + 快速測量能力。
- 橢圓偏光(如 FE-5000S)可提供更高靈敏度於極薄膜層的分析能力。
5. 選擇策略:什麼時候用哪一法?
下面是根據不同需求,選擇量測方法的建議:

實務上,有些設備可以結合兩種方法的優點,或者在開發、量產階段分別採用不同方式。
6. 應用示例與操作注意事項
應用示例
- 半導體晶圓製程中:使用顯微分光法快速檢測局部膜厚
- 高階光學鍍膜:對極薄高反膜,用橢圓偏光法做參數精算
- 異形 / 微結構樣品:顯微分光法可搭配顯微鏡對應結構位置量測
操作注意事項
- 校正與參考樣本:兩種方法皆需可靠的參考樣品進行校正
- 模型擬合選擇:尤其對橢圓偏光法,模型選擇好壞直接影響準確度
- 樣品表面處理:表面粗糙或異方性會對干涉或偏振造成誤差
- 光斑大小控制:小結構樣品需考慮光斑尺寸與取樣位置
- 背面反射影響:在透明基板時要注意來自背面反射的干擾(某些顯微分光儀有排除背面反射設計)
7. 結語與未來展望
當前薄膜技術日益進步,愈來愈多元與複雜的膜層結構使得厚度與光學參數量測更具挑戰性。未來可能出現以下趨勢:
- 混合量測法整合:結合顯微分光與橢圓偏光優勢的複合系統
- 自動化與 AI 擬合演算法:加速模型擬合流程,降低操作門檻
- 奈米等級高精度量測:對極薄膜(< 1 nm)量測能力持續提升
- 現場/線上應用:在製程中直接量測而不取樣
總之,選對合適的量測方法比單純追求“最精度”更重要。了解樣品特性、量測需求與設備限制,才能在成本與效率間取得平衡。
✅ 結尾推薦-量測能力媲美橢圓偏光儀的OPTM
在實務應用上,若量測需求涵蓋 從奈米級到數十微米的膜厚範圍,又同時希望能 針對微小區域快速定位與量測,顯微分光式量測系統會是較具彈性的選擇。

大塚科技推出的 OPTM 系列顯微反射式薄膜量測儀,結合了:
- 高速量測(對焦後 1 秒內完成)
- μm 等級量測光斑,可對應晶圓局部、MEMS、微結構
- 多波段光源支援透明 / 半透明 / 有色薄膜
- 具備背面反射抑制與多層膜擬合功能
因此,不僅可用於研發階段膜厚確認,也能整合於製程監控或來料檢查流程中,提高一致性與效率。
若你仍在猶豫顯微分光與橢圓偏光哪一種更適合,建議可以實際提供樣品進行測試比對,往往能更快速得出最佳方案。
臺灣大塚科技備有顯微分光OPTM的DEMO機,及專業量測人員。
跳脫過去薄膜只能用橢圓偏光的迷思,歡迎測試DEMO。
針對短期內沒有購機需求的客戶,我們也提供小量樣品付費委測服務,詳情請見付費委測服務按鈕!



















