
2026Q1法說會簡報:https://mopsov.twse.com.tw/nas/STR/692020260430M001.pdf
在生成式 AI 與高效能運算 (HPC) 橫掃全球半導體產業的當下,市場目光多聚焦於運算核心 GPU 與高速記憶體 HBM,然而筆者觀察到一個被低估的技術瓶頸:電力傳輸效率與熱能擴散管理。隨著單顆晶片功耗衝破 1,000 瓦大關,傳統的導線架與封裝結構已無法支撐極端的高電流負荷。當前的技術轉折點正處於從傳統封裝邁向系統級封裝 (SiP) 與面板級封裝 (FOPLP) 的關鍵節點,這不僅是物理尺寸的微縮,更是材料科學與結構工程的深度重構,旨在解決 1.6T 通訊時代下的訊號完整性與電力損耗難題。
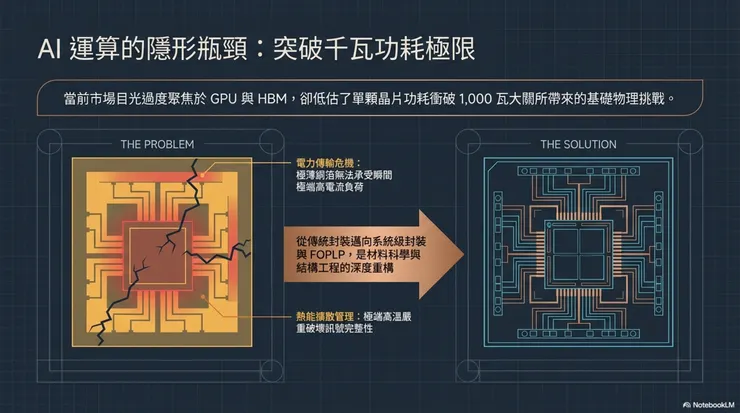

一、 恆勁科技(6920)近期營收動態分析
恆勁科技 (6920) 在 2026 年第一季展現了強勁的復甦態勢。
- 2026 年 3 月營收:1.43 億新台幣;月增率 (MoM):13.5%;年增率 (YoY):20.2% 2026 年 2 月營收:1.26 億新台幣;月增率 (MoM):-0.8%;年增率 (YoY):15.1% 2026 年 1 月]營收:1.27 億新台幣;月增率 (MoM):5.2%;年增率 (YoY):18.5% 2026 年 1 至 3 月累計營收:3.96 億新台幣,較去年同期成長 18.0%。
【財報指引】:公司於法說會中明確指出,2026 年第一季度的毛利率受惠於產品組合優化,高毛利的 C2iM® 系列產品佔比提升,加上產能利用率回升至 75% 以上,獲利結構已出現質變。2026 年全年度營收目標設定在 20% 以上的增長區間,且毛利率有望隨著二期擴產效益顯現而逐季走揚。
數據解讀: 筆者針對上述數據進行深度剖析發現,2026 年第一季的營收動能並非來自單一客戶,而是由 AI 伺服器電源管理與車用電子重啟拉貨雙引擎驅動。特別是在 3 月份營收衝破 1.4 億新台幣,創下近 24 個月來的新高,這代表 C2iM® 技術在 AI 高壓環境下的穩定性已獲得 Tier 1 客戶的大規模採納。營收成長主因 C2iM® 載板在 AI 電源管理晶片 (PMIC) 的滲透率大幅提升,且 2025 年獲得的德儀 (TI) 技術獎項開始轉換為實質訂單流。毛利率的大幅改善則來自於折舊高峰期已過,以及良率穩定後帶來的規模經濟。

二、 逐字稿精粹:技術與營運模塊
筆者整理本次法說會核心訊息,以下為營運發展的關鍵支柱:
- 國際標竿認可:恆勁科技 (6920) 榮獲德州儀器 (TI) 2025 年供應商技術發展卓越獎。筆者強調,此獎項在全球數千家供應商中僅選出極少數,而恆勁是唯一獲獎的載板業者。這標誌著其在「高功率密度」與「散熱效能」的技術路徑上,已被全球模擬晶片龍頭定義為次世代標準。

- 技術範疇轉型:公司目前正進行從特殊載板向面板級封裝 (FOPLP) 的全面戰略轉移。法說會數據顯示,目標在 2028 年將 FOPLP 的營收佔比提升至 60% 至 70%。筆者認為這是一種「降維打擊」的策略,利用大面積面板的生產效率,提供與晶圓級封裝相近的佈線密度,但成本更具競爭力。
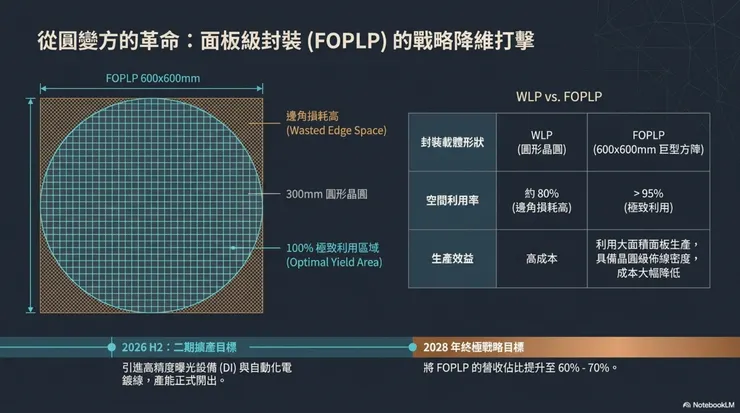
- 車用安全性突破:針對車用電子最重視的焊點可靠度,公司開發出 Wettable Flank 設計,已通過 MSL1 最高等級可靠度測試。這解決了傳統封裝在自動光學檢測 (AOI) 時的死角問題,能顯著降低車廠的檢測成本與潛在召回風險。
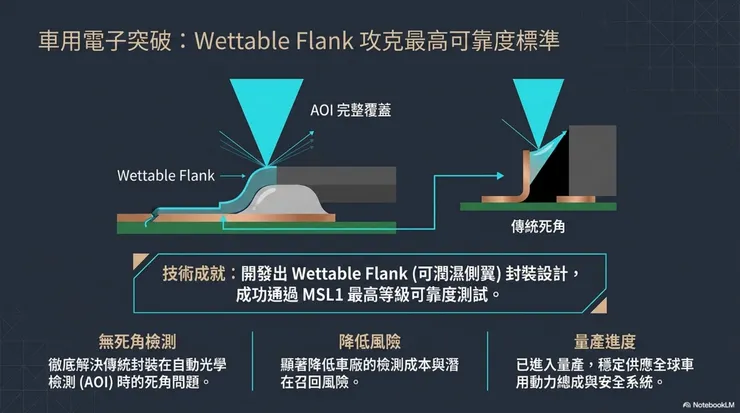
- 1.6T 高速通訊佈局:隨通訊協定邁向 1.6T 與 CPO (共封裝光學),訊號完整性對寄生電感的要求極為苛刻。C2iM® 技術透過縮短 1L 轉 3L 的傳輸路徑,能有效降低訊號損耗,目前已與美股網通大廠進行早期設計導入 (Design-in)。
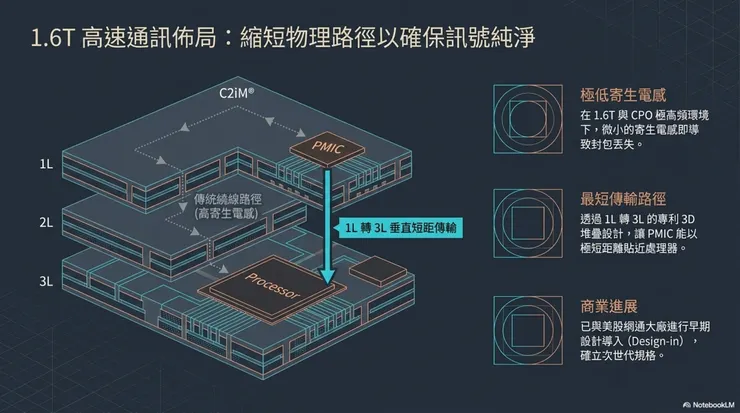
- 熱管理黑科技:法說會首次揭露微流道 (Microfluidics) 散熱載板的進度。這是在載板內部嵌入微型液冷通道,將散熱層直接貼近矽晶片熱源,目標鎖定 TDP 超過 1,200 瓦的超高算力晶片。
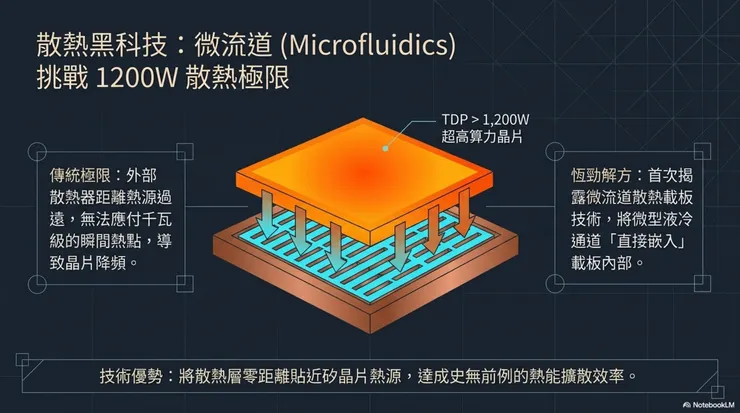
三、 產業聯想:美股與台股的聯動邏輯
筆者觀察全球半導體供應鏈,技術的風向球始終由美股領頭羊引領,而台股受惠端則負責將技術規模化。
美股領頭羊:德州儀器 (TXN)。 作為全球 PMIC 的霸主,德州儀器對封裝規格的變更具有引領作用。當 TXN 決定採用基於 C2iM® 技術的載板來封裝其高階電源晶片時,這代表整個 AI 伺服器與工業 4.0 的電力系統都將跟進。
台股受惠端與觀察名單:
- 恆勁 (6920):核心技術持有者。其 C2iM® 技術平台是解決 AI 電源瓶頸的關鍵,目前正處於從研發投入期轉向獲利爆發期的十字路口。
- 臻鼎-KY (4958):策略盟友與股東。身為全球 PCB 龍頭,臻鼎與恆勁在載板技術上的合作,有助於恆勁在量產規模與全球客戶網絡上的擴張。
- 日月光投控 (3711):下游封測整合者。隨著 SiP 與 FOPLP 趨勢確立,日月光與載板廠的技術整合將更為緊密,共同對抗中國封測廠的低價競爭。
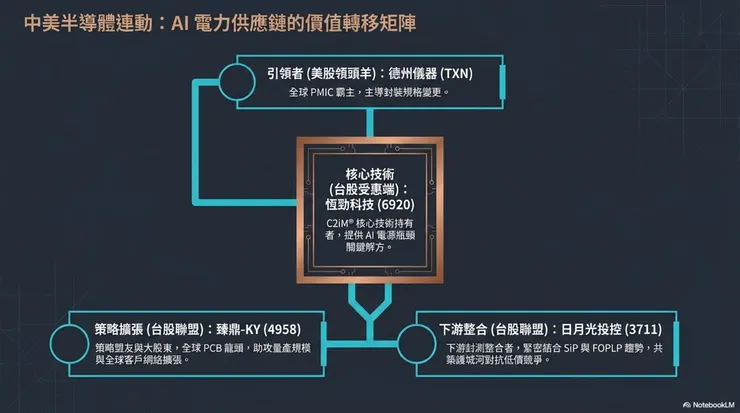
四、 技術與產能深度分析:C2iM® 與 FOPLP 的物理優勢
筆者在研究恆勁的技術護城河時發現,其核心競爭力在於 C2iM® (Component Embedded in Metallic substrate) 的結構設計。這不僅是把元件埋進去,更是對電子流向與熱流向的精確控制。
- 厚銅工藝的必要性:AI 晶片在瞬間運作時需要極大的電流供應。傳統載板的銅箔厚度有限,難以承載突發的高電流,且容易因溫升導致線路斷裂。恆勁採用厚度達 70um 的厚銅設計,配合獨家的大銅柱 (Cu Pillar) 技術,能大幅降低阻抗,減少電力傳輸過程中的能源浪費。
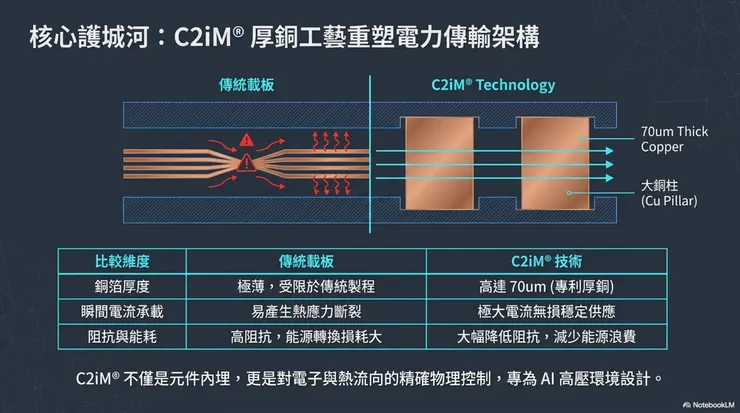
- 1.6T 傳輸與訊號完整性:在 1.6T 的極高頻環境下,任何微小的寄生電感都會導致數據封包丟失。筆者分析,恆勁的 C2iM® 技術透過 3D 堆疊結構,讓 PMIC 能以最短路徑貼近處理器,這不僅省電,更重要的是維持了訊號的純淨度。

- FOPLP (面板級封裝) 的大戰略: 筆者認為,半導體封裝正在經歷「從圓變方」的革命。晶圓級封裝 (WLP) 受限於圓形晶圓的邊角損耗,空間利用率僅約 80%。而面板級封裝採用 600mm x 600mm 的方型結構,利用率可提升至 95% 以上。恆勁在法說會中提到的 2028 年目標,正是看準了面板生產設備帶來的吞吐量優勢。
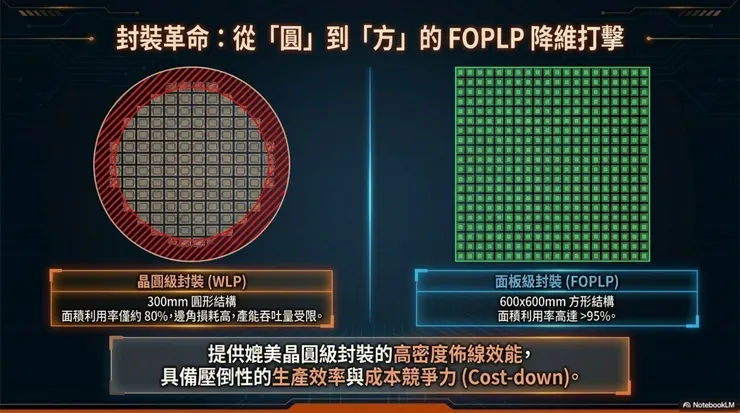
- 資本支出與新廠進度: 公司目前的二期擴產計畫主要集中在自動化電鍍線與高精度曝光設備 (DI)。筆者估算,隨著 2026 年下半年產能陸續開出,將能支應 FOPLP 客戶的強勁需求。資本支出雖然在短期內會增加折舊費用,但考量到 FOPLP 產品的高單價特性,其產值目標將遠超傳統產線。

五、 投資觀點
筆者對恆勁科技 (6920) 的投資邏輯總結如下:
結論:恆勁正處於從「特殊載板商」轉型為「先進封裝關鍵供應商」的結構性轉折點。
營運分析:
- 獲利拐點顯現:2026 年第一季 18% 的營收成長僅是開端,隨著毛利率受惠產品組合優化而走揚,獲利增速將顯著快於營收增速。
- 客戶深度綁定:TI 技術獎項是極強的背書,這保證了公司在未來 3 至 5 年內,於 AI 電源管理市場的領導地位。
- 技術具備稀缺性:C2iM® 技術整合了厚銅、內埋與 FOPLP,目前市場上能同時提供這三種解決方案的業者極少,具備強大的定價權。
- 估值重新定義:市場過去將其視為傳統 PCB 或載板廠,但隨 FOPLP 佔比提升,應將其視為先進封裝 (Advanced Packaging) 產業的一環,享有更高的估值倍數。

六、 Q&A 整理:法說會核心問答
- Q1:2026 年第一季毛利率改善的主要原因為何?
- A1:筆者分析,主要來自產品組合優化。高毛利的 C2iM® 產品在 AI 電源管理晶片市場滲透率提升,加上產能利用率從低谷回升,固定成本分攤效果顯著。
- Q2:FOPLP 技術對公司未來的意義?
- A2:FOPLP 是公司實現 2028 年願景的核心。透過大面積封裝技術,能大幅降低 AI 與 HPC 晶片的封裝成本,並提供優於傳統載板的電氣表現,目標是成為公司最大營收來源。
- Q3:獲得德儀 (TI) 技術獎項對訂單有何具體挹注?
- A3:這代表恆勁的技術已進入 TI 的核心研發路徑。未來 TI 新一代的電源管理產品將優先考量恆勁的載板規格,形成事實上的技術標準。
- Q4:1.6T 傳輸與 CPO 技術對恆勁有何影響?
- A4:1.6T 環境下對訊號干擾極其敏感,C2iM® 的短路徑與低感抗設計能有效解決此問題,公司已與多家網通巨頭展開前瞻性研發合作。
- Q5:車用電子的最新進展?
- A5:Wettable Flank 設計已通過最高可靠度驗證並進入量產,主要供應全球車用動力總成與安全系統,目前需求穩定增長。
- Q6:二期擴產的進度與資金規劃?
- A6:擴產按計畫進行中,資金主要用於購買 FOPLP 關鍵設備。預計 2026 年下半年產能開始釋放,支應 2027 年的爆發性增長。
- Q7:如何看待大陸競爭對手的價格戰?
- A7:恆勁深耕的是高技術門檻的特殊載板與 FOPLP 領域,涉及厚銅、內埋等複雜工藝,並非傳統大量產的 PCB 產品,因此受價格戰影響較小。

免責聲明:筆者所提供之產業分析內容,均基於法說會公開資訊與公開財務數據,旨在提供技術趨勢與產業邏輯之參考。筆者並無提供具體買賣建議,投資人應自行評估市場風險並審慎決策。本文內容受著作權法保護,嚴禁未經授權之轉載。















