在二十一世紀進入第三個十年,半導體產業正經歷一場前所未有的結構性變革。隨著傳統摩爾定律在極紫外線(EUV)微縮路徑上遭遇物理極限與成本效益的雙重壓迫,半導體效能的增長動能已正式從「前端晶圓製造」轉向「後端先進封裝」。這場革命的核心標誌,便是台積電(TSMC)預計於2026年啟動試產、並於2028至2029年邁入量產的次世代面板級封裝技術——CoPoS(Chip-on-Panel-on-Substrate)。
晶圓級到面板級:先進封裝的範式轉移與物理極限突破
過去數年,人工智慧(AI)的爆發性成長對算力提出了近乎貪婪的需求。輝達(NVIDIA)的H100、B200等晶片,之所以能展現強大的運算力,很大程度上歸功於台積電的CoWoS(Chip-on-Wafer-on-Substrate)技術 。然而,隨著晶片尺寸(Die Size)不斷膨脹,以及高頻寬記憶體(HBM)堆疊數量的激增,傳統以12吋(300mm)圓形矽晶圓作為載體的中介層封裝模式,正逐漸觸及物理與經濟的雙重天花板 。圓形晶圓在處理大型方形AI晶片時,其面積利用率存在先天缺陷。數據顯示,在12吋晶圓上切割方形晶片,邊緣區域會產生大量的無效空間 。例如,輝達的Blackwell B200晶片在12吋晶圓上僅能放置16顆,相較於前代H100的29顆,產出效率大幅衰減 。更具挑戰的是,當封裝尺寸超過光罩極限的9.5倍時,生產成本與良率控制將變得極為困難 。CoPoS技術的精髓在於「化圓為方」,將封裝載體從圓形的矽晶圓更換為巨大的方形面板(Panel),藉此實現面積利用率的飛躍性提升 。
封裝載體面積利用率比較分析
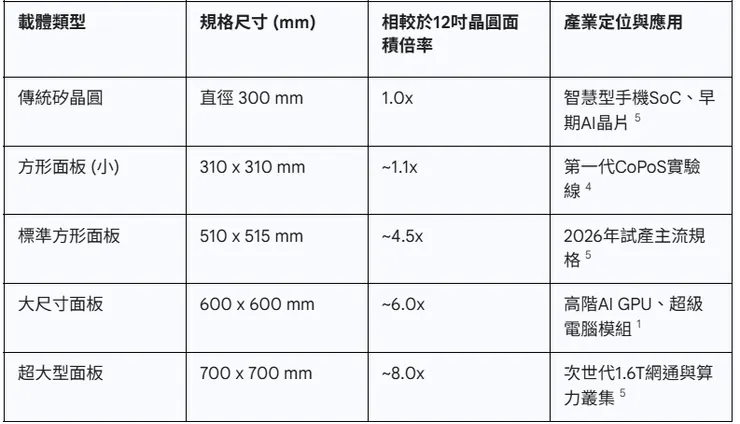
從上表可見,轉向面板級封裝能讓單次製程所涵蓋的晶片數量大幅增加,理論上可將單位面積成本降低20%至30% 。這不僅僅是產能的擴張,更是為了應對未來「Agentic AI」(自主代理AI)時代對超級算力模組的低成本規模化需求 。
專有名詞深度解構:透視CoPoS的技術基因
為了理解2026年的產業大趨勢,必須先釐清一系列在專業領域中頻繁出現、卻往往令外界困惑的技術術語。這些技術雖然聽起來深奧,但若以「現代建築工程」為類比,其實不難理解。
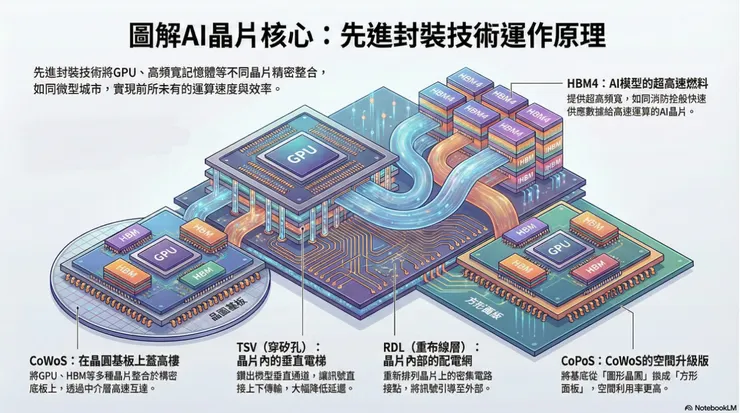
1. CoWoS(晶片堆疊於晶圓基板):2.5D封裝的標竿
CoWoS的全名是Chip-on-Wafer-on-Substrate。簡單來說,它就像是在一個大型的精密底板(Wafer)上,同時蓋起多棟功能不同的建築(GPU運算晶片、HBM高頻寬記憶體),再透過底板內部的地下通道(中介層)讓這些建築之間能以極速進行電力與數據交換 。目前這項技術主要分為CoWoS-S(使用矽中介層,效能最頂尖)、CoWoS-R(使用重布線層,成本較低)以及CoWoS-L(結合矽橋接技術,適合超大型封裝)。
2. CoPoS(晶片堆疊於面板基板):面板級的升級版
CoPoS(Chip-on-Panel-on-Substrate)是CoWoS的演進形態。其核心差異在於將底座從「圓形的矽晶圓」換成了「方形的面板」 。這就像是將原本在圓形花園裡蓋大樓,改到一個巨大的正方形工業區施工,空間利用效率更高,且能同時容納更多組複雜的晶片模組 。
3. RDL(重布線層):晶片內部的微型電路網
RDL全稱為Redistribution Layer。在CoPoS製程中,RDL負責將晶片密集的電路接點重新排列,引導至外部的載板或PCB上。它就像是城市裡的配電網,將變電所的高壓電轉換為民生用電並分流到各家各戶。在CoPoS中,面板級RDL技術是決定訊號完整性的關鍵。
4. HBM4:次世代AI的燃油
HBM(High Bandwidth Memory)是高頻寬記憶體。當AI晶片運算速度極快時,需要像「消防栓」一樣供水速度極快的記憶體。2026年預計量產的HBM4,將與CoPoS技術深度整合,提供超過15 TB/s的頻寬,這是支撐超大型AI模型推理的基礎 。
5. TSV(穿矽孔):垂直傳輸的電梯
TSV全稱為Through-Silicon Via,是在矽中介層中鑽出的微型垂直通道,填充金屬後用於導電。它就像是大樓裡的電梯,讓訊號不需要繞遠路,可以直接垂直上下,大幅降低延遲與功耗 。
2026年產業關鍵時程與設施布局
根據台積電與法人的最新布局資訊,2026年將是先進封裝產業從單純擴產轉向技術迭代的轉折點 。台積電在台灣嘉義科學園區的AP7廠區,以及美國亞利桑那州的布局,已勾勒出未來五年的算力版圖。
台積電嘉義AP7廠的階段性規劃
嘉義AP7廠是台積電目前規模最大、技術層級最高的先進封裝據點,規劃分八期建設,每期廠房肩負不同的技術使命 。
- P1廠房:專為蘋果(Apple)設計的WMCM(晶圓級模組化晶片模組)產線,預計於2026年進入投產階段 。
- P2、P3廠房:鎖定SoIC(3D堆疊)技術,應對高效能運算晶片對垂直整合的需求 。
- P4、P5廠房:這將是CoPoS技術的主戰場。CoPoS部分,研發落腳在竹科,而首條CoPoS實驗線則在采鈺(6789)建置,預計年後展開進機,目標2027年則進入技術開發階段、2028年展開製程驗證,預計2028年底以後(即年底至2029年間)正式進入大規模量產。供應鏈則透露,CoPoS原先量產廠選在嘉義,現正評估轉向南科或龍潭。
此外,台積電位於亞利桑那州的先進封裝廠也預計於2028年動工,將分別部署SoIC與CoPoS產線,以因應美系客戶對「主權AI」與在地供應鏈的安全需求 。這種「多點布局、網狀協作」的策略,強化了台灣在全球AI時代的關鍵地位 。
先進封裝產能預估

輝達Rubin架構:CoPoS技術的終極催化劑
所有的技術革新都需要一個具備商業規模的「殺手級應用」。對於CoPoS而言,這個應用就是輝達預計於2026年CES展會上正式發布的「Rubin」架構GPU 。
Rubin平台(R100)代表了AI算力的下一個維度。為了因應大規模語言模型(LLM)不斷增長的複雜度,Rubin晶片的功耗預計將達2.3kW,約為Blackwell B200的1.6倍 。在物理結構上,Rubin需要將兩顆3奈米的運算核心(Compute Dies)與高達12層的HBM4記憶體緊密堆疊在一起。這對中介層的面積提出了前所未有的要求——傳統的12吋晶圓已無法在保持良率的同時提供足夠的作業面積,這迫使輝達成為台積電CoPoS技術的首個錨點客戶(Anchor Tenant)。
由於高階AI晶片失效的成本極高,產業鏈在2026年將出現「良率保險」的投資邏輯轉移。設備與測試廠商的角色不再僅僅是提供產能,而是確保這些單價數萬美元的晶片在封裝與測試過程中萬無一失。這也是為何晶圓測試(CP)與系統級測試(SLT)市場在2026年將迎來爆發,預計測試產值年增率將高達34% 。
玻璃基板(Glass Substrate):先進封裝的新「地基」
在CoPoS的技術進程中,材料的變革同樣關鍵。長期以來,半導體載板主要使用有機材料(如ABF載板),但當晶片尺寸超過100mm x 100mm時,有機基板在封裝過程的高溫下會像烤魷魚般捲曲,這種現象被稱為「翹曲」(Warpage)。
為了解決這個物理障礙,2026年的產業共識正轉向「玻璃基板」。玻璃具有極高的剛性(模量是有機材料的4至5倍)和優異的熱穩定性,能確保在大尺寸面板製程中保持絕對平整 。
玻璃基板與傳統有機基板性能對比

目前,台積電正與全球玻璃巨頭康寧(Corning)緊密合作驗證玻璃面板製程。同時,英特爾(Intel)已在亞利桑那州運行專用的玻璃基板設施,而三星(Samsung)則利用其面板事業部的優勢,加速在韓國世宗市建設生產線,目標在2026年第四季實現量產 。
矽光子(Silicon Photonics)與 CPO:光進銅退的產業革命
隨著資料中心傳輸速率從800G邁向1.6T,傳統的「銅線傳輸」已達到物理極限。銅線在高頻傳輸下會產生巨大熱能且訊號衰減嚴重,這迫使產業轉向「以光代銅」 。
2026年被定調為矽光子與CPO(Co-Packaged Optics,共同封裝光學)的大規模商轉元年。CPO技術的核心理念是將負責光電轉換的「光引擎」直接搬到GPU或交換器晶片旁邊,共同封裝在同一個基板上 。
關鍵技術拼圖:ELS 外置雷射源
在CPO架構中,雷射光源(發光點)對熱極度敏感。如果將雷射與發熱量驚人的GPU封裝在一起,雷射效能會迅速雪崩。因此,業界發展出ELS(External Laser Source)架構。這就像是「燈泡掛外面,開關在裡面」——將雷射光源放在伺服器機櫃最通風的前面板(ELS模組),再透過特殊的保偏光纖將光「送」進深處的CPO晶片 。這種冷熱分離的策略,是讓CPO技術商業化的關鍵拼圖。
台灣供應鏈廠商介紹:CoPoS 生態系的核心力量
台灣半導體產業鏈在CoPoS與先進封裝的浪潮中,不僅提供代工服務,更在設備開發、材料供應與測試驗證上展現了強大的技術護城河 3。
1. 前端製造與實驗線夥伴
- 台積電 (2330):全球技術領導者,主導CoPoS標準。其2026年資本支出預計落在520億至560億美元之間,大量投資於先進封裝 。
- 采鈺 (6789):台積電子公司,專精於光學元件封裝。2026年將承擔台積電首條CoPoS實驗線的運作任務,是技術開發初期的重要據點 。
- 日月光投控 (3711):全球OSAT龍頭。其先進封裝產能將在2026年底提升至20 Kwpm,並積極推動自有的FoCoS面板級封裝方案(600x600mm規格)。
2. 設備供應鏈:CoPoS 的硬實力
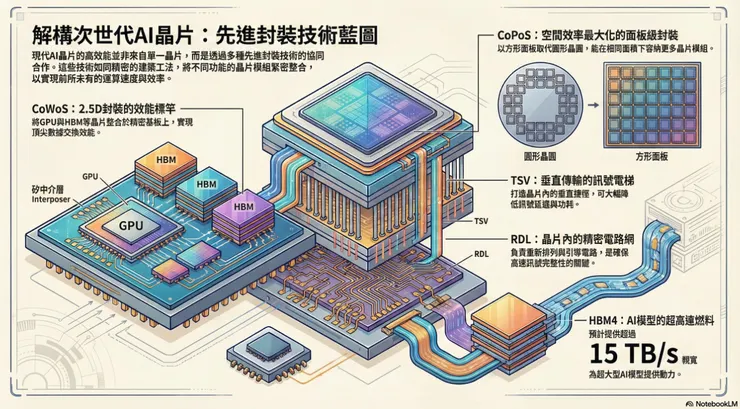
CoPoS技術涉及將傳統晶圓搬運系統更改為大尺寸面板搬運系統,這為台灣設備商創造了巨大的替代商機 。

3. 基板與關鍵材料:地基穩固者
隨著載板產業在2026年全面復甦,ABF族群正迎來由AI伺服器結構化升級帶動的「量價齊揚」 。
- 欣興 (3037):高階技術領跑者,已與主要晶片大廠展開「玻璃基板」封裝技術的量產規劃。2025年底高階載板占比已突破50%,營收展望樂觀。
- 南電 (8046):產品對載板報價上漲極為敏感。隨著800G交換器與AI PC換機潮在2026年展開,南電營運正從谷底強勁反彈。
- 華通 (2313):HDI板龍頭。除了衛星板業務外,華通的高階HDI技術在人形機器人頭部模組與AI加速器板上具有顯著優勢。
- 台玻 (1802):提供關鍵的低損耗玻纖布(T-Glass)。由於此材料主要由美日廠壟斷且產能有限,台玻在供需缺口達20%的背景下,獲利空間顯著修復。
4. 矽光子(CPO)先鋒隊
- 上詮 (3363):光纖陣列連接器(FAU)技術領導者,已進入輝達與台積電的聯合開發名單。預計其1.6T CPO相關產品將在2026年第三季進入量產。
- 訊芯-KY (6451):在CPO模組封裝上具有領先優勢,是市場公認的核心受惠股,並與英特爾在封測領域有長期合作。
- 聯鈞 (3450):旗下源傑科技切入矽光雷射與800G以上高階產品。法人預估其2026年營收上看155億元,EPS有望挑戰10元大關。
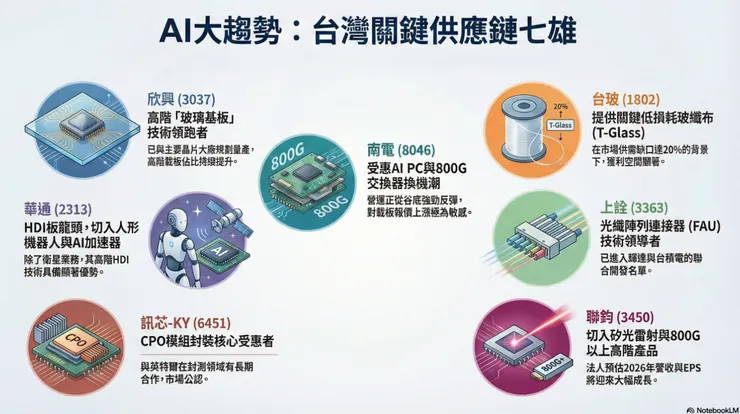
深度觀察:2026年後的產業新秩序
CoPoS 技術的導入,不僅僅是封裝載體形狀的改變,它預示著半導體與顯示(Display)、材料科學之間的界限正在模糊。
設備投資邏輯轉移
在傳統製程中,設備廠商的價值來自於生產效率。但在CoPoS時代,設備商的價值正轉變為「良率保證人」。法人分析指出,未來相關資本支出的投資重點將落在檢測、清洗與精密對位。因為當單片面板上承載著數十顆單價極高的AI晶片時,任何一處製程微塵都可能導致數百萬台幣的損失。這種「容錯率近乎零」的製造環境,讓具備高階檢測技術的本土供應鏈(如致茂、志聖)獲得了前所未有的議價權。
主權AI與全球化2.0
地緣政治的因素正在深刻影響先進封裝的地理分布。隨著各國推動「主權AI」(Sovereign AI),建設本國的算力叢集,掌握先進封裝能力已成為國安層級的議題 。台積電將CoPoS產能布局於台灣嘉義與美國亞利桑那,體現了在保持核心技術留台的同時,實現全球風險分散的「網狀協作」。這也帶動了台灣設備商全球化布局,例如上詮在泰國設廠以對美出貨,鈦昇在全球設立據點以支援Intel與Samsung等大廠。
浸沒式冷卻(Immersion Cooling)的興起
由於CoPoS技術封裝的AI模組(如Rubin)功耗飆升至2.3kW以上,傳統的氣冷與液冷技術逐漸捉襟見肘。2026年,市場將開始關注與CoPoS技術配套的「浸沒式散熱」方案。透過將伺服器直接浸泡在不導電的介電液中,散熱速度可比傳統方式快上30%。台灣廠商如台達電、緯穎等,正積極開發相關解決方案,以應對算力猛獸帶來的散熱挑戰。
結論與建議
總結,2026年是半導體「面板級封裝」與「矽光子」大規模商轉的雙重元年。CoPoS技術以其卓越的面積利用率與成本優勢,正成為AI晶片領導廠商突破物理極限的首選。對於投資者與產業界而言,應跳脫傳統的「晶圓代工」思維,轉而關注:
- 設備商的良率保險價值:優先關注具備光學計量、高精密清洗與複雜系統測試能力的本土設備廠。
- 材料端的玻璃化趨勢:玻璃基板及其上游材料(如低損耗玻纖布)的缺口將是2026年的獲利熱點。
- 矽光子生態系的整合度:關注能與台積電、博通、輝達等大廠深度綁定的CPO封裝與連接器廠商。
半導體產業的下一個十年,將由「封裝」定義。當AI晶片不再受限於圓形的矽晶圓,而是以方形面板的形式大規模產出時,這場算力革命才真正進入了爆發期。台灣憑藉著從嘉義AP7廠到完整的設備材料生態系,已然在2026年的算力大賽中搶占了最有利的位置。
在未來的五年內,我們將見證晶片模組逐漸演變為「系統級封裝」(System-on-Package),其威力將足以媲美當今一整個伺服器機櫃的算力。CoPoS技術不僅是技術的升級,它是推動人類社會邁向通用人工智慧(AGI)時代的關鍵物理基石。

透過CoPoS與CPO技術,正努力將上式中的互連功耗降至最低,以釋放每一焦耳電力的最大運算潛能。
資料來源
- 《台積電次世代面板級封裝技術2026年啟動Copos重塑封裝新格局》 (新電子科技雜誌)
- 《TSMC Races to Scale CoWoS and Deploy Panel-Level Packaging for NVIDIA’s Rubin Era》 (Financial Content)
- 《台積電嘉義先進封裝廠AP7進機!2座CoWoS新廠拚明後年量產》 (工商時報 / Yahoo 股市)
- 《台積電CoPoS封裝技術大突破!2026年試產引爆設備供應鏈新商機》 (CMoney / 權知道)
- 《先進封裝擴產加速:OSAT 產能成長期動能》 (TechNews)
- 《2026年載板產業全面復甦?欣興領軍ABF族群強力反彈》 (Sinotrade / Today LINE)
- 《玻璃基板概念股:4檔台灣玻璃基板廠商介紹》 (Roo.cash)
- 《為什麼是強化玻璃?兩大物理極限的逼迫》 (Vocus)
- 《2026年CPO大商轉:光通訊時代正式啟動》 (Yahoo 新聞 / 理財周刊)
- 《什麼是CPO (共同封裝光學)?ELS外部雷射源定義》 (PressPlay / 口袋學堂)
- 《浸沒式散熱運作原理與台灣廠商投入現狀》 (數位時代)
- 《CoWoS、CoPoS、CoWoP 差異詳解》 (TechNews / 數位時代)

















