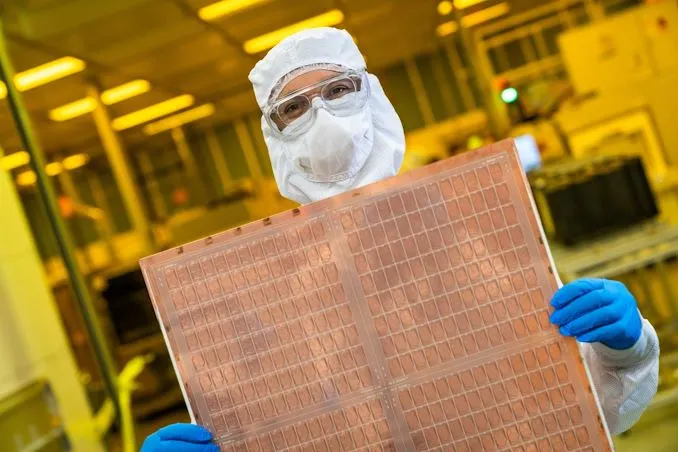
當我們打開一台手機、一部筆電,裡頭那顆方方正正、黑色的處理器晶片,看起來就像是科技的核心。但其實,這顆晶片並不是獨立存在的。晶片(chip)必須依附在一塊「基板」(substrate)上,才能真正運作。
基板就像是晶片的地基,負責把晶片裡的微小訊號與電力,傳遞到主機板,再連到整台裝置的其他元件,例如記憶體、電源、輸入輸出介面。這層基板看起來像是一塊綠色小板子,上面密密麻麻佈滿金屬線路與連接球,它幾乎不會出現在產品包裝上,也鮮少被報導。但如果沒有它,晶片就無法跟任何東西說話,更別提驅動整台裝置了。從晶圓廠走出來的晶片,最終會被焊接到這層基板上,並封裝成一顆顆我們熟悉的處理器,再裝進我們手上的電子產品裡。而隨著 AI 晶片越做越大、越來越複雜,這塊原本被忽略的底座,反而成了下一場半導體革命的主角。
傳統基板的極限:尺寸、訊號與熱的三重壓力
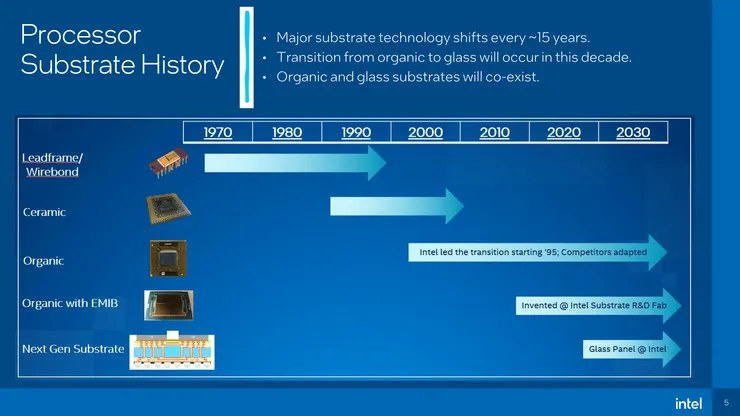
從 1970 年代的 wirebond、1990 年代的 ceramic、到今日普遍使用的有機層壓板(organic substrate),這塊不起眼的綠色底板已被逼近極限。現在,Intel 把下一代的希望,壓在了玻璃上。
過去二十年,撐起大多數晶片的,是一種叫做有機基板(organic substrate)的材料。它是用像玻璃纖維這樣的編織材料壓合成板,再在表面鍍上金屬導線與銅球,提供晶片接腳與主機板之間的橋樑。這種技術成熟、成本低,是今天絕大多數 CPU、GPU、手機晶片的標準做法。但隨著晶片變得越來越複雜,有機基板開始跟不上。
AI 時代的到來,不只需要更強的計算能力,還需要在同一個封裝裡放入更多晶片(chiplets)。這代表
- 封裝要夠大,才能容納更多晶片
- 線路要夠密,才能支援高速傳輸
- 結構要夠穩,才能承受散熱與電力需求的提升
基板的關鍵職能包含
- 從晶片接腳轉接到主機板接腳(微米到毫米的尺度轉換)
- 承載高速訊號與穩定電力輸送
- 提供結構與散熱支持
這三項任務對材料與尺寸的要求越來越高,而有機基板的熱膨脹、結構翹曲、訊號損耗等限制,正悄悄成為封裝效能的天花板。
玻璃基板 Glass Core Substrate 是什麼?
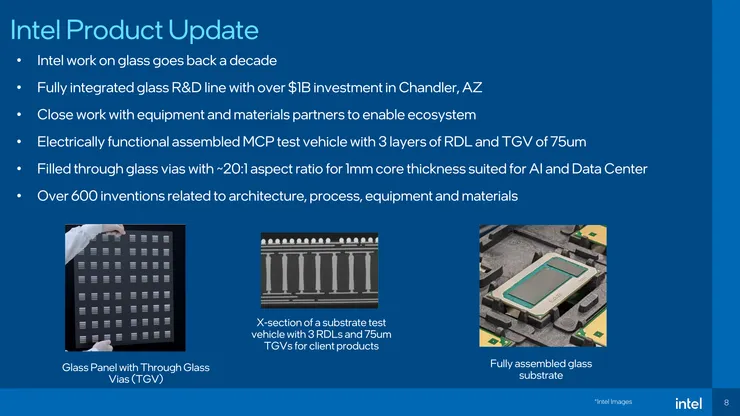
玻璃基板(Glass Core Substrate)是以強化玻璃作為基板核心,並在其上下堆疊 重新分佈層(RDL) 與 Through-Glass Vias(TGV)穿孔導通結構,實現電力傳輸與訊號連接功能。與傳統有機基板相比,玻璃基板具備五大革命性優勢
- 結構穩定性:CTE(熱膨脹係數)更接近矽晶片,熱循環不易翹曲,提高良率與封裝壽命。
- 尺寸精度與大面積:支援最大可至 240×240 mm 封裝區域,容納 50% 更多晶片,適合多 chiplet 高密度封裝。
- 高密度訊號:穿孔密度為傳統基板 10 倍,支援更細走線與高速訊號,準備支援 448G I/O 傳輸。
- 整合電源供應:支援整合式 IPD(Integrated Power Delivery),簡化主板功率結構、減少功耗與延遲。
- 高溫製程兼容:可承受更高溫製程階段,利於堆疊多層金屬與電源模組整合。
為什麼這不是單純的材料替換?
Intel 強調效能極限;TSMC 尋求規模與成本的落地應用
Intel 砸下超過 10 億美元,投資在亞利桑那 Chandler 的玻璃基板研發中心,強調這不只是封裝創新,更是與自家先進製程(如 18A、14A)、EMIB、Foveros 等封裝技術整合的關鍵拼圖。玻璃基板不只是要解決有機基板撐不住 AI 晶片的問題,更要變成 Intel Foundry(IFS)對外提供差異化的利器。
台積電並未全盤複製 Intel 的玻璃基板路線,它選擇從 FOPLP(Fan-Out Panel-Level Packaging) 切入。基板也用玻璃,但主打面板級封裝邏輯,以方形大面積提升面積利用率(>95%),降低封裝成本。相較 Intel 聚焦在 先進晶片封裝與高階 HPC、AI 應用,TSMC 則希望讓玻璃基板落地於 成熟製程或中高階應用,在封裝密度與良率間找到折衷。



























