摘要: 均華精密於2025年9月5日舉辦第三季法人說明會,聚焦AI晶片需求爆炸性成長,揭示超過10倍速的未來技術藍圖。介紹CoreOS及WMCM封裝技術進展,並強調Solter與Bundle設備在高良率生產中的關鍵作用。上半年營收達12億元,預計下半年將再創新高。會中展示47年半導體經驗及AI檢測技術優勢,展望參加SEMICON展覽,深化全球布局。
會議摘要
開場與公司概況
均華精密(股票代碼6640)於2025年9月5日舉行2025年第三季法人說明會。會中回顧公司自2010年成立,2018年成功上市(IPO)。總部位於土城,另設新竹、台中、高雄據點,服務全球客戶。均華擁有47年半導體封裝經驗,專注先進封裝製程設備,產品包括Chip Sorter與Die Bonder,營收中先進封裝占比已達85%。
AI晶片與技術趨勢
介紹AI晶片需求自2023年起呈跳躍式成長,運算速度、記憶體容量及晶片顆數均以倍數增長,預計未來將超過10倍速。核心技術包括CoreOS系列封裝(S、R、L型),以及WMCM(下一代Info產品),應用於Logitech、機器人及數據中心。投影片展示CoWoS、Chiplet、SoIC技術演進,2023-2027年間晶片模組從2D升級為多層結構,滿足高運算需求。
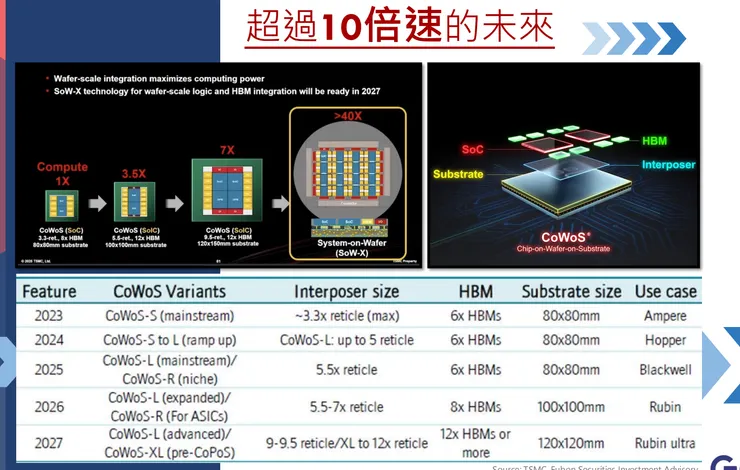
產品與設備優勢
均華的核心設備Sorter(挑選裝置)與Bonder(高精度綁定)透過AOI(自動光學檢測)技術,實現100%良率。Solter追蹤晶片生產履歷,確保正確分配至Dream Module(如RobotX或人型機器人);Bundle則支援大尺寸晶片檢測,過濾切割瑕疵。新增EFEM與串機模組,提升自動化生產效率。HybridBundle與Jigsaw產品正開發中,瞄準0.1微米精度挑戰。

營運成果


市場與客戶合作
均華服務台灣晶圓廠及國際客戶,與TSMC、AMD等設計大廠合作。投影片顯示,CoreOS L需求2024-2027年倍數成長,WMCM產能亦擴張。客戶需求高精度設備,均華提供客製化模組,支援多層晶片組合(如ZenV Login從2+8升級至X2)。






















